Precision Wire Bonding Heights & Loop
Microsembly's in-depth knowledge of precision wire bonding, coupled with our focus on continuous improvement, enables us to consistently meet or exceed the requirements of the most demanding RF/microwave applications. Our expertise instills confidence that the final assembled product will achieve design specifications and endure environmental stressors over the product lifetime. We recognize that wire bonds must be engineered to minimize deleterious effects on signals. Short wire lengths and double wedge bonds are employed to reduce inductance and reflections. All wire bonding is conducted according to rigorous procedures aimed at maximizing RF performance and reliability. Pull and shear testing is routinely performed before and after to verify robust wire bonds that will withstand thermal cycling and mechanical stresses.
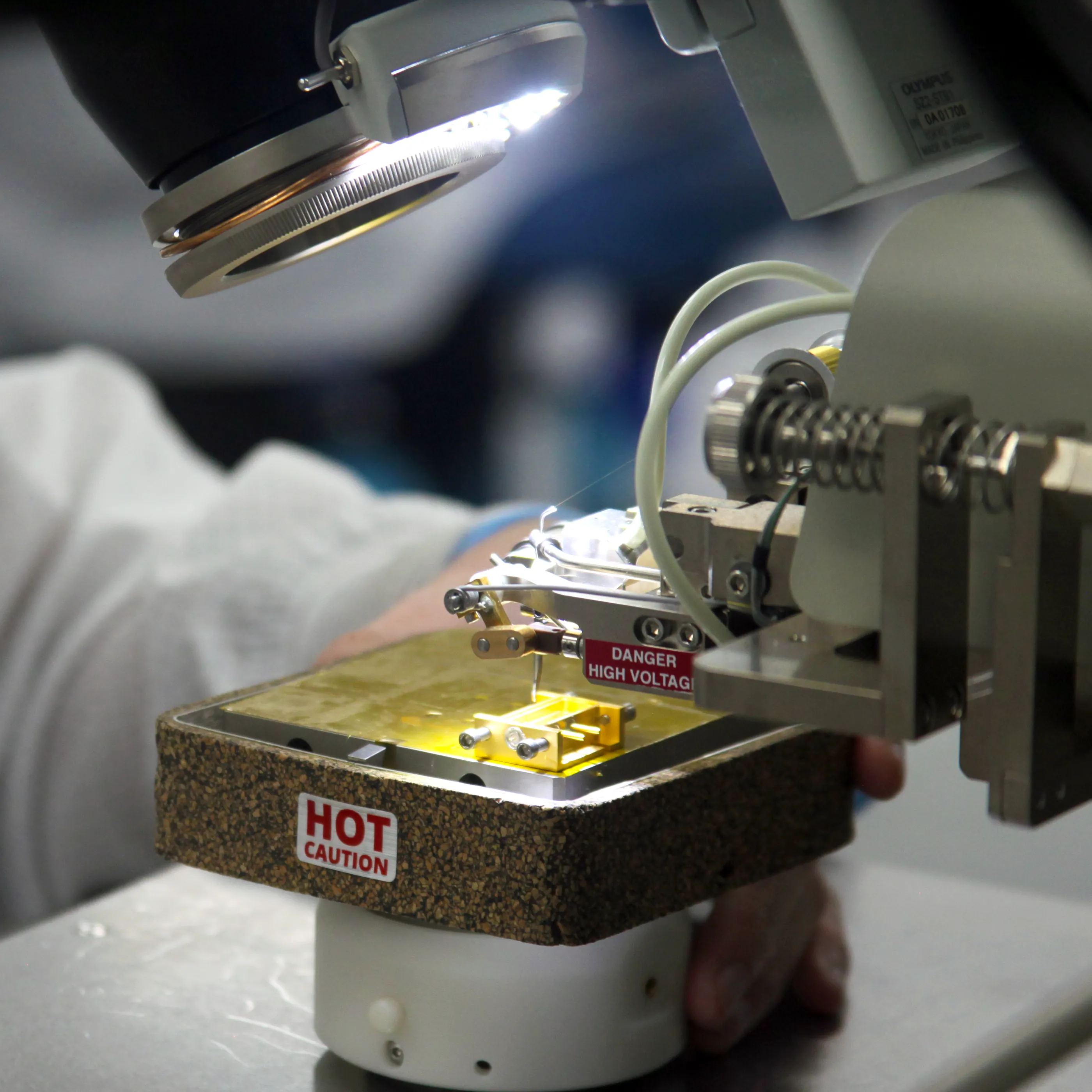
Ball Bonding:
Microsembly performs gold (Au) ball bonding for wire diameters ranging from 0.0007" (17 μm) to 0.002" (50 μm), enabling fine pitch interconnections. Ball bonding processes utilize thermocompression or ultrasonic energy to join gold wire to aluminum or gold contact pads. We employ optimized bonding parameters and advanced techniques including reverse bonding, die-to-die bonding, and deep access bonding at varying heights within packages. These capabilities facilitate low loop profiles and complex interconnects between multiple die or substrate levels. Our extensive expertise in gold ball bonding is applied across a wide variety of packages, including ceramic packages, open-cavity plastic encapsulated packages, and printed circuit boards (PCBs). With rigorous process controls for bond quality and comprehensive reliability testing, we achieve precision ball bonding that withstands thermomechanical stresses and enables reliable electrical conduction within demanding microelectronic assemblies.
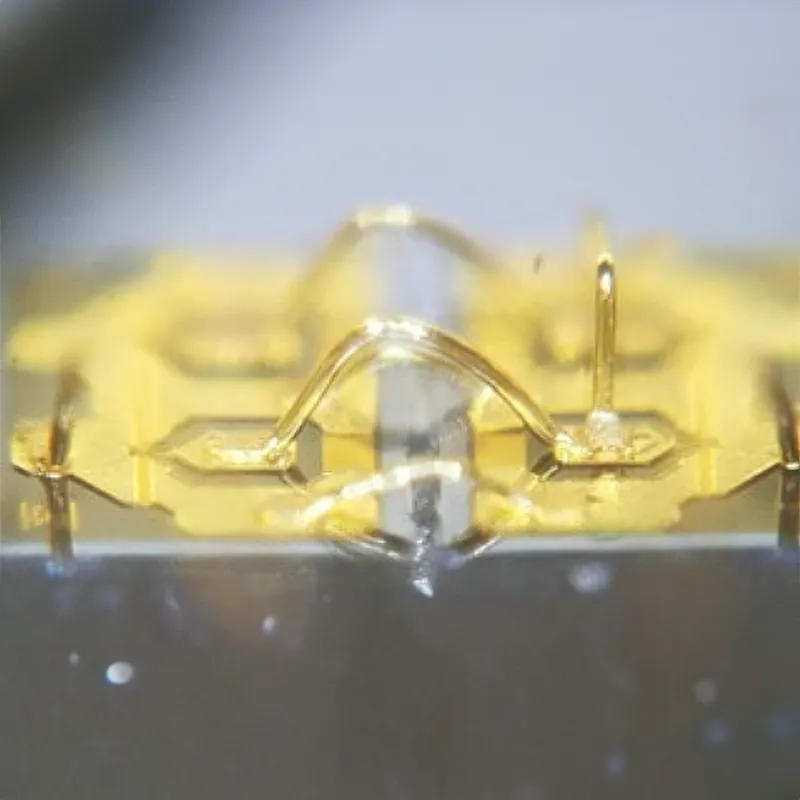
Wedge Bonding:
Microsembly performs aluminum (Al) or gold (Au) wedge bonding using wire diameters from 0.0007" (17 μm) to 0.002" (50 μm). Wedge bonding relies on ultrasonic energy and force to deform the wire and fuse it to contact pads. Our extensive expertise enables precision control of wire loop heights and spacing, which are often critical parameters for high-frequency electrical performance. Process monitoring and optimization focuses on bond quality, minimizing heel cracks and achieving consistent shape and strength. For applications sensitive to loop inductance, low profile wedge bonds are implemented. All wedge bonding adheres to rigorous procedures for cleanliness, visual inspection, pull/shear testing, and other quality assurance measures. This ensures reliable interconnections that meet the most demanding mechanical and electrical requirements of microwave assemblies and other high-performance devices. Our knowledge of wedge bonding processes and metrology allows us to consistently achieve uniform bonds optimized for the operating conditions and life cycle of the application.

Ribbon Bonding:
Microsembly has capabilities in gold (Au) ribbon bonding for applications where the cross-sectional area of round wire bonds is insufficient. We bond gold ribbons ranging from 0.002" (50 μm) to 0.010" (250 μm) in width and 0.00025" (6 μm) to 0.001" (25 μm) in thickness. The larger surface area of ribbon bonds provides higher current capacity and lower resistance compared to traditional wire interconnects. Ribbon bonding employs thermosonic bonding processes to achieve metallurgical joining of gold ribbons between contact pads or substrates. Optimized bonding force, power, and time are utilized to realize strong, low-resistance interconnections without damage. Ribbon orientation, loop shape, and bond placement are carefully controlled. Rigorous post-bond testing confirms electrical conductivity and tensile strength meet specifications prior to encapsulation. With our expertise in ribbon bonding, we can accommodate high current and high frequency designs where wire bonds reach performance limitations. Ribbon-based interconnections provide a reliable, low-impedance electrical conduit well-suited for the most demanding microwave and power electronic assemblies.